按测试内容分类。半导体测试就是通过测量半导体的输出响应和预期输出并进行比较以确定或评估集成电路功能和性能的过程,其测试内容主要为电学参数测试。一般来说,每个芯片都要经过两类测试:
1、参数测试。参数测试是确定芯片管脚是否符合各种上升和下降时间、建立和保持时间、高低电压阈值和高低电流规范,包括DC(DirectCurrent)参数测试与AC(AlternatingCurrent)参数测试。DC参数测试包括短路测试、开路测试、最大电流测试等。AC参数测试包括传输延迟测试、建立和保持时间测试、功能速度测试等。这些测试通常都是与工艺相关的。CMOS输出电压测量不需要负载,而TTL器件则需要电流负载。2、功能测试。功能测试决定 芯片 的内部数字逻辑和模拟子系统的行为是否符合期望。这些测试由输入适量和相应的响应构成。他们通过测试芯片内部节点来检查一个验证过的设计是否正产工作。功能测试对逻辑电路的典型故障有很高的覆盖率。

测试成本与测试时间成正比,而测试时间取决于测试行为,包括低速的参数测试和高速的矢量测试(功能测试)。其中参数测试的时间与管脚的数目成比例,适量测试的时间依赖于矢量的数目和时钟频率。测试的成本主要是功能测试。按生产流程分类。半导体测试可以按生产流程可以分为三类:验证测试、晶圆测试测试、封装检测。
(1)验证测试:又称实验室测试或特性测试,是在器件进入量产之前验证设计是否正确,需要进行功能测试和全面的AC/DC。特性测试确定器件工作参数的范围。通常测试最坏情况,因为它比平均情况更容易评估,并且通过此类测试的器件将会在其他任何条件下工作。
(2)晶圆测试:每一块加工完成后的芯片都需要进行晶圆测试,他没有特性测试全面,但必须判定芯片是否符合设计的质量和需求。测试矢量需要高的故障覆盖率,但不需要覆盖所有的功能和数据类型。晶圆测试主要考虑的是测试成本,需要测试时间最小,只做通过/不通过的判决。
(3)封装测试:是在封装完成后的测试。根据具体情况,这个测试内容可以与生产测试相似,或者比生产测试更全面一些,甚至可以在特定的应用系统中测试。封装测试最重要的目标就是避免将有缺陷的器件放入系统之中。
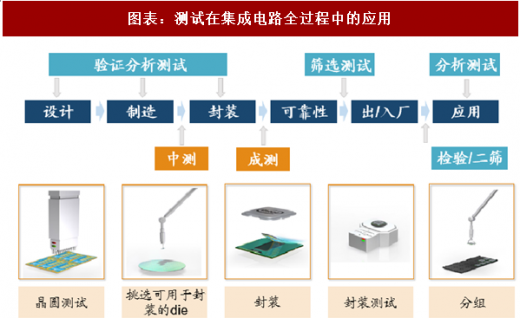
晶圆 测试又称前道测试、“Circuitporbing”(即CP测试)、“Waferporbing”或者“Diesort”。晶圆测试大致分为两个步骤:1)单晶硅棒经标准制程制作的晶圆,在芯片之间的划片道上会有预设的测试结构图,在首层金属刻蚀完成后,对测试结构图进行晶圆可靠性参数测试(WAT)来监控晶圆制作工艺是否稳定,对不合格的芯片进行墨点标记,得到芯片和微电子测试结构的统计量;2)晶圆制作完成后,针对制作工艺合格的晶圆再进行CP测试(CircuitProbing),通过完成晶圆上芯片的电参数测试,反馈芯片设计环节的信息。完成晶圆测试后,合格产品才会进入切片和封装步骤。
参考观研天下发布《 2018年中国半导体市场分析报告-行业运营态势与发展前景研究 》
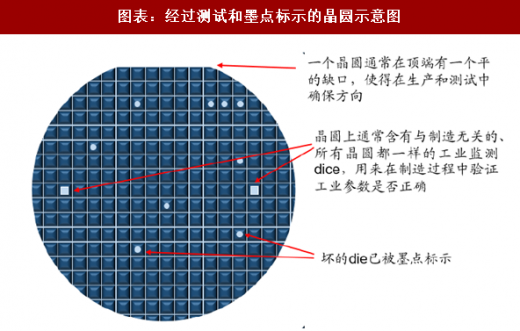
封装测试:在一个Die封装之后,需要经过生产流程中的再次测试。这次测试称为“Finaltest”(即通常说的FT测试)或“Packagetest”、成品测试。在电路的特性要求界限方面,FT测试通常执行比CP测试更为严格的标准。芯片也许会在多组温度条件下进行多次测试以确保那些对温度敏感的特征参数。商业用途(民品)芯片通常会经过0℃、25℃和75℃条件下的测试,而军事用途(军品)芯片则需要经过-55℃、25℃和125℃。
不同测试环节的测试参数和应用场景稍有区别。晶圆测试的对象是未划片的整个晶圆,属于在前端工序中对半成品的测试,目的是监控前道工艺良率,并降低后道封装成本。而成品测试是对完成封装的集成电路产品进行最后的质量检测,主要是针对芯片应用方面的测试,有些甚至是待机测试,以保证出厂产品的合格率。CP测试与成品测试的测试参数大体是相似的,但由于探针的容许电流有限,CP测试通常不能进行大电流测试项。此外,CP测试的常见室温为25℃左右,而成品测试有时需要在75-90℃的温度下进行。


【版权提示】观研报告网倡导尊重与保护知识产权。未经许可,任何人不得复制、转载、或以其他方式使用本网站的内容。如发现本站文章存在版权问题,烦请提供版权疑问、身份证明、版权证明、联系方式等发邮件至kf@chinabaogao.com,我们将及时沟通与处理。